电子束晶圆检测,是扫描电子显微镜(SEM)技术的应用,其使用高能电子与晶圆表面的物质发生相互作用时所激发出的信息进行成像,然后再通过图像处理和运算来实现对晶圆缺陷、关键尺寸等进行检测的目的。
电子束检测以聚焦电子束作为检测源,入射电子束激发出二次电子,然后通过对二次电子的收集和分析捕捉到缺陷或者关键尺寸。主要用于半导体元件的缺陷(Defects)、关键尺寸(Critical Dimension)等检验,以电性缺陷(Electrical defects)为主,形状缺陷(Physical defects)次之。此外,由于检测源为电子束,检测结果不受某些表面物理性质例如颜色异常、厚度变化或前层缺陷的影响,因此电子束检测还可用于检测很小的表面缺陷例如栅极刻蚀残留物等。
电子束晶圆检测系统由电子枪、电磁透镜、收敛透镜、物镜、导向器、探测器、后端成像系统以及真空系统、高真空精密运动系统等部件组成,系统结构如下图所示:
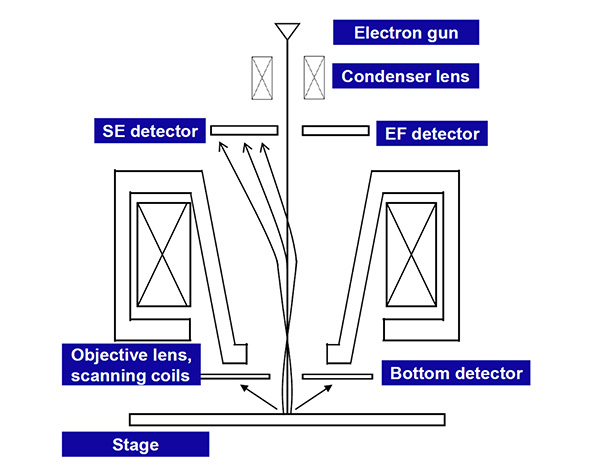
电子束检测系统示意图(图片来源自网络)
以下重要指标用以衡量电子束晶圆检测系统的表现:
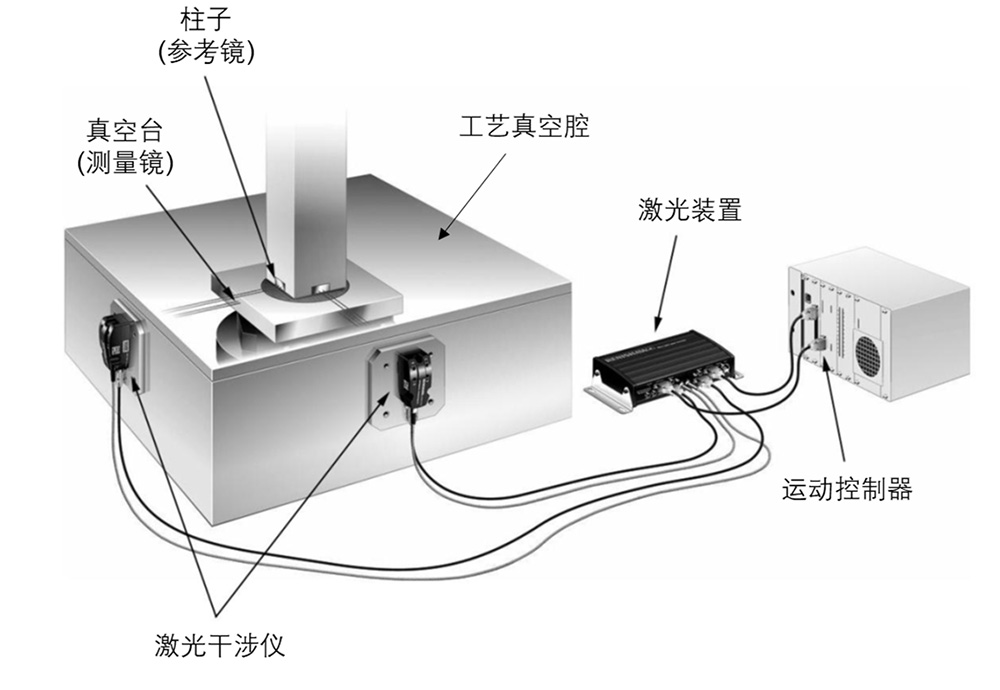
电子束晶圆检测系统中真空运动系统示意图(图片来源自网络)
隐冠半导体基于多年的真空产品和高端运动系统的开发经验,针对电子束晶圆检测设备开发的高真空XY台已实现批量化生产,已给国内多家相关企业批量供货,且在国内头部Fab厂稳定运行,其位置稳定性可达±2nm,速度均匀性<0.1%(速度为100mm/s)。可广泛应用于电子束缺陷检测(E-beam Defects inspection)、电子束关键尺寸检测(CD-SEM)、电子束缺陷复查(Review-SEM)等。高真空静电吸盘也已完成研发并实现批量化生产,给国内多家客户供货,且在国内头部Fab厂稳定运行。
隐冠除了可以提供高精度真空运动系统之外,针对相关核心零部件做了大量国产化工作,包括且不限于真空双频激光干涉仪、真空压电电机、静电吸盘控制器、高真空运动线缆等。